熱管理解決方案 - 為電子製造商賦能
當前,電子行業技術創新日新月異,推動產品向體積更小、速度更快的方向發展,使得電路板冷卻問題成為了一個主要挑戰。這種趨勢也帶動了對更高性能和更具成本效益的熱管理方案的需求。控制電子器件溫度的能力直接影響了產品的穩定性、質量、使用壽命和成本。
如今,越來越多的熱界面材料(TIM)和技術可供選擇,給工程師們提供了極大便利,使得他們很容易地排除掉不切實際的熱管理方案。
熱界面材料的種類
電路板的操作在很大程度上決定了熱界面材料的種類和應用工藝。製造商們可選擇各種導熱材料,如導熱黏合劑、導熱化合物、導熱脂、導熱膏、導熱墊片、導熱帶和封裝劑。
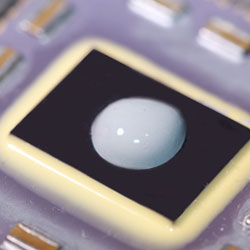 |
 |
 |
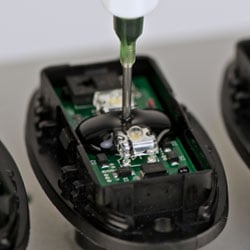 |
| 導熱黏合劑 |
非固化型導熱化合物、導熱脂、導熱膏和導熱凝膠 |
導熱墊和導熱帶 |
導熱封裝材料 |
| 導熱黏合劑可永久地將散熱片固定在印刷電路板(PCB)的發熱元件上。單組份黏合劑易于涂覆,但雙組份環氧黏合劑通常更為牢固。無需額外的結構件來固定散熱片,同時,在不超過尺寸公差和保證足夠黏結度的情況下,可讓膠層厚度盡可能地薄。黏合劑具有比較好的導電性,但其導熱性卻不如非固化型導熱化合物,盡管沒有滲出或者完全變干的風險。不建議將導熱黏合劑用于需要修復或升級的電路板。 |
固化材料由填充了導熱材料的增稠基液組成。它們非常黏稠,可以降低滲出的幾率。毛細作用填充了散熱片和安裝表面之間的微小間隙,通過減少熱阻來改善熱傳遞。滲出和完全變干是導熱脂最明顯的劣勢,因此,當需要考慮到這些因素時, 固化型化合物更為合適。
|
導熱片和導熱帶應用簡單,無需固化,并且可預制尺寸,最適合用于要求半永久膠層和裝配時間短的情況。導熱墊可能會變得“干燥”,意思是它們不含黏合劑,或者含有比環氧或黏合劑更低黏結強度的壓敏型黏合劑。
|
導熱封裝材料可劃分為兩類:遮蓋整個電路板的灌封化合物,以及遮蓋電路板上特定元件或部分電路板的圓頂包封劑。這些材料可為電路板提供電絕緣作用時,還具有防沖擊、防振動、防環境污染物和防生產后變化因素的作用。灌封化合物和圓頂包封劑通常為單組份或者雙組份化合物,在添加填料后,則可起到散熱和電絕緣的作用。
|
熱管理材料的組成
可以說,大部分熱界面材料都由兩個部分組成:基料和填料。在選擇基料時,要考慮到它們的介電強度、固化時間、黏度和其它與應用直接相關的機械性能。填料的唯一目的是散熱,并且,只有其含量足夠高時,才能起到散熱的作用。不過,填料如果含量過高,則可能對電路板和點膠設備產生研磨作用。
基料
• 硅酮
• 聚氨酯
• 丙烯酸
• 礦物油
• 酯類油
• 焊料和易熔合金,如鎵、錫、銦、鉛和/或鉍
填料
• 金屬粉末:銀、鋁、銅、鋅和金,以及各種金屬。
• 金屬氧化物(陶瓷)和金屬氮化物(無機):氧化鈹、氧化鋁、氧化鋅、二氧化硅、氮化硼、氮化鋁和混合物。
• 碳基材料:金剛石、碳纖維、石墨或石墨烯。
安士澳黏合劑可供應各類熱管理材料,同時,我們也不斷在探尋新的技術和材料,以期幫助電子製造商制造出更小、更快、更強的產品。我們的主要熱管理材料製造商包括:3M、Bergquist、Dow、Henkel LOCTITE/ResinLab和Techspray.
文章來源:https://www.ellsworth.com/insights/white-papers/thermal-management-solutions/